QR Code

Prodotti
Contattaci

Telefono

Fax
+86-579-87223657

E-mail

Indirizzo
Wangda Road, Ziyang Street, contea di Wuyi, città di Jinhua, provincia di Zhejiang, Cina
La lucidatura chimico-meccanica (CMP) rimuove il materiale in eccesso e i difetti superficiali attraverso l'azione combinata di reazioni chimiche e abrasione meccanica. Si tratta di un processo chiave per ottenere la planarizzazione globale della superficie del wafer ed è indispensabile per le interconnessioni in rame multistrato e le strutture dielettriche a basso k. Nella produzione pratica, il CMP non è un processo di rimozione perfettamente uniforme; dà origine a tipici difetti dipendenti dal modello, tra i quali la concavità e l'erosione sono i più importanti. Questi difetti influenzano direttamente la geometria degli strati di interconnessione e le loro caratteristiche elettriche.
Il termine concavo si riferisce alla rimozione eccessiva di materiali conduttivi relativamente morbidi (come il rame) durante la CMP, che porta ad un profilo concavo a forma di piatto all'interno di una singola linea metallica o di un'ampia area metallica. In sezione trasversale, il centro della linea metallica si trova più in basso dei suoi due bordi e della superficie dielettrica circostante. Questo fenomeno si osserva frequentemente in linee larghe, piazzole o regioni metalliche a blocchi. Il suo meccanismo di formazione è principalmente legato alle differenze nella durezza del materiale e alla deformazione del tampone di lucidatura su ampie caratteristiche del metallo: i metalli teneri sono più sensibili ai componenti chimici e agli abrasivi presenti nell'impasto liquido e la pressione di contatto locale del tampone aumenta su ampie caratteristiche, facendo sì che la velocità di rimozione al centro del metallo superi quella ai bordi. Di conseguenza, la profondità dell'incavo aumenta solitamente con la larghezza della linea e il tempo di lucidatura eccessiva.
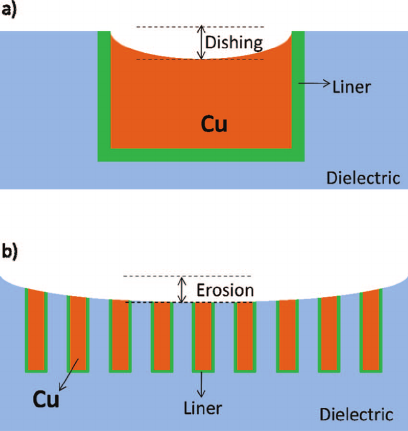
L'erosione è caratterizzata dal fatto che l'altezza della superficie complessiva nelle regioni ad alta densità di pattern (come line array metallici densi o aree con riempimento fittizio denso) è inferiore a quella delle regioni sparse circostanti dopo CMP. In sostanza, si tratta di una rimozione eccessiva di materiale a livello regionale, guidata dalla densità del modello. Nelle regioni dense, il metallo e il dielettrico insieme forniscono un'area di contatto effettiva più ampia e l'attrito meccanico e l'azione chimica del tampone e dell'impasto liquido sono più forti. Di conseguenza, i tassi medi di rimozione sia del metallo che del dielettrico sono più elevati rispetto alle regioni a bassa densità. Man mano che la lucidatura e la lucidatura eccessiva procedono, lo stack metallo-dielettrico nelle aree dense diventa più sottile nel suo complesso, formando un gradino di altezza misurabile, e il grado di erosione aumenta con la densità del modello locale e il carico del processo.
Dal punto di vista delle prestazioni dei dispositivi e dei processi, l'incurvatura e l'erosione hanno molteplici impatti negativi sui prodotti a semiconduttori. Il Dishing riduce l'effettiva area della sezione trasversale del metallo, portando a una maggiore resistenza di interconnessione e caduta IR, che a loro volta causano un ritardo del segnale e un margine di temporizzazione ridotto sui percorsi critici. Le variazioni nello spessore dielettrico causate dall'erosione modificano la capacità parassita tra le linee metalliche e la distribuzione del ritardo RC, minando l'uniformità delle caratteristiche elettriche attraverso il chip. Inoltre, l’assottigliamento dielettrico locale e la concentrazione del campo elettrico influenzano il comportamento alla rottura e l’affidabilità a lungo termine dei dielettrici intermetallici. A livello di integrazione, un'eccessiva topografia superficiale aumenta la difficoltà di messa a fuoco e allineamento della litografia, degrada l'uniformità della successiva deposizione e incisione della pellicola e può indurre difetti come residui metallici. Questi problemi si manifestano in definitiva come fluttuazione della resa e una riduzione della finestra del processo. Pertanto, nell'ingegneria pratica, è necessario controllare la conformazione e l'erosione entro limiti specificati attraverso l'equalizzazione della densità del layout e l'ottimizzazionelucidatura sfrettaselettività e messa a punto dei parametri di processo CMP, in modo da garantire la planarità delle strutture di interconnessione, prestazioni elettriche stabili e una solida produzione in grandi volumi.



+86-579-87223657


Wangda Road, Ziyang Street, contea di Wuyi, città di Jinhua, provincia di Zhejiang, Cina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Tutti i diritti riservati.
Links | Sitemap | RSS | XML | politica sulla riservatezza |
