QR Code

Prodotti
Contattaci

Telefono

Fax
+86-579-87223657

E-mail

Indirizzo
Wangda Road, Ziyang Street, contea di Wuyi, città di Jinhua, provincia di Zhejiang, Cina
I substrati in carburo di silicio hanno molti difetti e non possono essere elaborati direttamente. È necessario coltivare su un processo epitassiale per creare wafer epitassiali per creare wafer epitassiali. Questo film sottile è lo strato epitassiale. Quasi tutti i dispositivi in carburo di silicio sono realizzati su materiali epitassiali. I materiali epitassiali omogenei in carburo di silicio di alta qualità sono la base per lo sviluppo di dispositivi in carburo di silicio. Le prestazioni dei materiali epitassiali determinano direttamente la realizzazione delle prestazioni dei dispositivi in carburo di silicio.
I dispositivi in carburo di silicio ad alta corrente e ad alta affidabilità hanno presentato requisiti più rigorosi sulla morfologia superficiale, la densità dei difetti, l'uniformità del doping e dello spessore dei materiali epitassiali. Densità di grandi dimensioni, bassa difetto e alta uniformitàEpitassia in carburo di silicioè diventato la chiave per lo sviluppo dell'industria del carburo di silicio.
La preparazione di alta qualitàEpitassia in carburo di silicioRichiede processi e attrezzature avanzate. Il metodo di crescita epitassiale in carburo di silicio più utilizzato è la deposizione di vapore chimico (CVD), che presenta i vantaggi del controllo preciso dello spessore epitassiale del film e della concentrazione di doping, meno difetti, tasso di crescita moderato e controllo automatico del processo. È una tecnologia affidabile che è stata commercializzata con successo.
L'epitassia CVD in carburo di silicio utilizza generalmente la parete calda o l'equipaggiamento CVD a parete calda, che garantisce la continuazione dello strato epitassiale 4H Crystal SIC in condizioni di temperatura di crescita più elevate (1500-1700 ℃). Dopo anni di sviluppo, la parete calda o la parete calda CVD possono essere divise in reattori orizzontali della struttura orizzontale e reattori verticali della struttura verticale in base alla relazione tra la direzione del flusso di gas di ingresso e la superficie del substrato.
La qualità del forno epitassiale in carburo di silicio ha principalmente tre indicatori. Il primo è la performance di crescita epitassiale, tra cui l'uniformità dello spessore, l'uniformità del doping, il tasso di difetto e il tasso di crescita; Il secondo è le prestazioni della temperatura dell'apparecchiatura stessa, tra cui la velocità di riscaldamento/raffreddamento, temperatura massima, uniformità della temperatura; e infine le prestazioni dei costi dell'attrezzatura stessa, tra cui il prezzo unitario e la capacità di produzione.
CVD orizzontale a parete calda, CVD planetario a parete calda e CVD verticale a parete quasi foro sono le soluzioni tecnologiche di apparecchiature epitassiali tradizionali che sono state applicate commercialmente in questa fase. Le tre attrezzature tecniche hanno anche le proprie caratteristiche e possono essere selezionate in base alle esigenze. Il diagramma della struttura è mostrato nella figura seguente:

Il sistema CVD orizzontale a parete calda è generalmente un sistema di crescita di grandi dimensioni a valle guidato dalla flottazione dell'aria e dalla rotazione. È facile ottenere buoni indicatori in onda. Il modello rappresentativo è PE1O6 della società LPE in Italia. Questa macchina può realizzare caricamento automatico e scarico di wafer a 900 ℃. Le caratteristiche principali sono un alto tasso di crescita, breve ciclo epitassiale, buona coerenza all'interno del wafer e tra le forni, ecc. Ha la quota di mercato più alta in Cina.

Secondo i rapporti ufficiali di LPE, combinati con l'utilizzo dei principali utenti, i prodotti wafer epitassiale 4H-SIC da 100-150 mm (4-6 pollici) 4H con uno spessore inferiore al 30μm prodotto dalla fornace epitassiale PE1O6 non può raggiungere la surficità epitassiale ≤, la surficità intrafonta densità ≤1cm-2, area priva di difetti superficiali (cella unitaria 2 mm × 2 mm) ≥90%.
Aziende nazionali come JSG, CETC 48, Naura e NASO hanno sviluppato attrezzature epitassiali in carburo di silicio monolitico con funzioni simili e hanno raggiunto spedizioni su larga scala. Ad esempio, nel febbraio 2023, JSG ha rilasciato un'attrezzatura epitassiale SIC a doppio rispetto da 6 pollici. L'attrezzatura utilizza gli strati superiori e inferiori degli strati superiori e inferiori delle parti di grafite della camera di reazione per far crescere due wafer epitassiali in un singolo forno e i gas di processo superiore e inferiore possono essere regolati separatamente, con una differenza di temperatura epitassiale.Parti a mezzamoia per rivestimento SIC. Stiamo fornendo parti da 6 pollici e da 8 pollici per i mezzosangue per gli utenti.

Il sistema CVD planetario a parete calda, con una disposizione planetaria della base, è caratterizzato dalla crescita di più wafer in un singolo forno e un'efficienza di uscita elevata. I modelli rappresentativi sono l'attrezzatura epitassiale della serie AIXG5WWC (8x150mm) e G10-SIC (9 × 150mm o 6 × 200mm) di Aixtron della Germania.
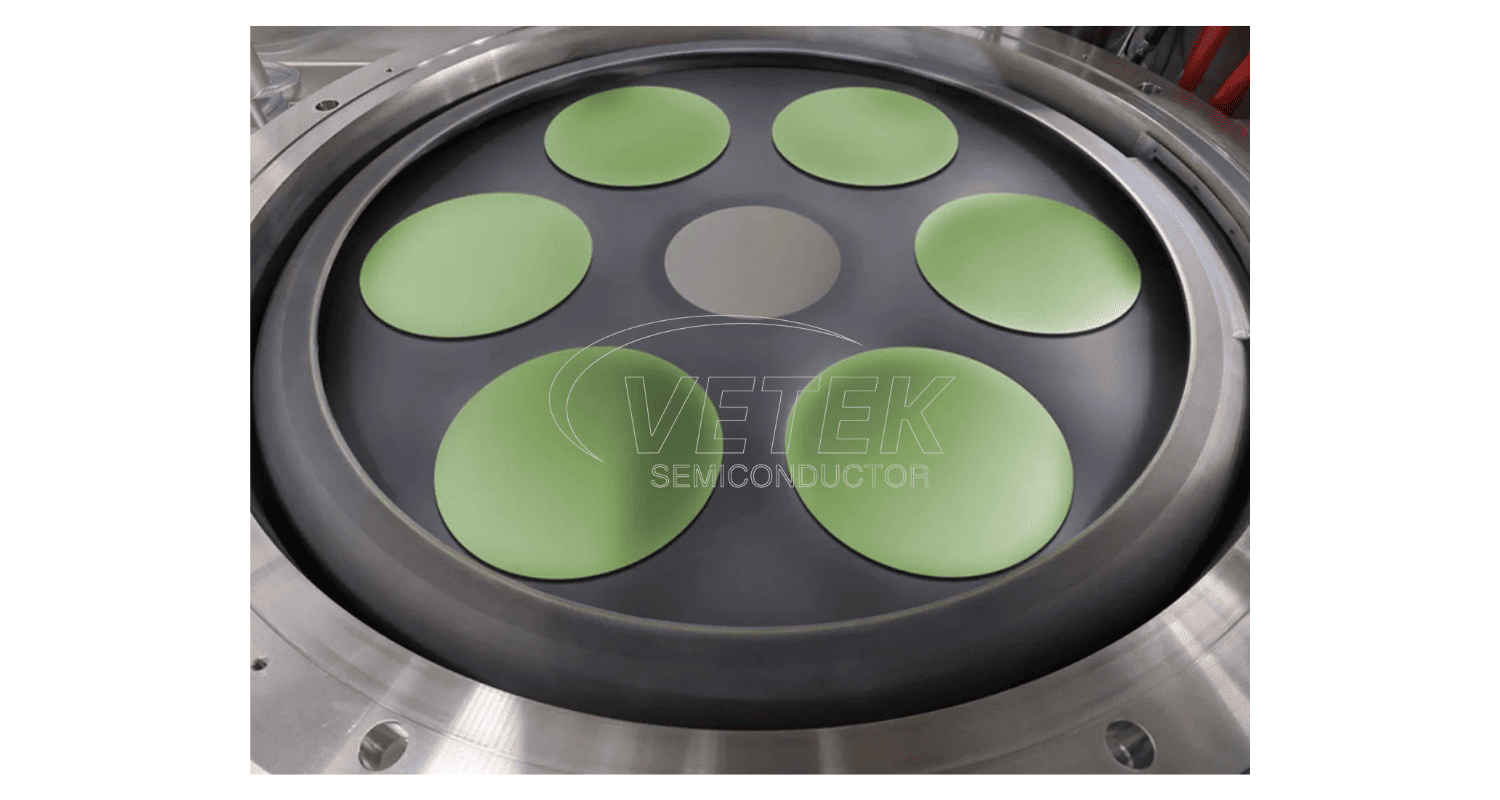
Secondo il rapporto ufficiale di Aixtron, i prodotti wafer epitassiale da 6 pollici da 6 pollici con uno spessore di 10 μm prodotto dalla fornace epitassiale G10 possono stabilmente raggiungere i seguenti indicatori: deviazione di concentrazione epitassiale di spessore epitassiale di ± 5%, deviazione di concentrazione epitassiale di ± 2%, invalido epitassiale, deviazione di concentrazione epitassiale intra-wafer di ± 2%, intrafunzione epitassiale di deviazione di concentrazione epitassiale di epitassiale di sola. Concentrazione non uniformità <2%.
Fino ad ora, questo tipo di modello viene utilizzato raramente dagli utenti domestici e i dati di produzione batch sono insufficienti, il che in una certa misura limita la sua applicazione ingegneristica. Inoltre, a causa delle elevate barriere tecniche dei forni epitassiali multi-wafer in termini di controllo del campo di temperatura e di flusso, lo sviluppo di apparecchiature domestiche simili è ancora nella fase di ricerca e sviluppo e non esiste un modello alternativo. Nel frattempo, possiamo fornire un suscettore del pianetario Aixtron come 6 pollici e 8 pollici con rivestimento TAC o rivestimento SIC.
Il sistema CVD verticale quasi-wall ruota principalmente ad alta velocità attraverso l'assistenza meccanica esterna. La sua caratteristica è che lo spessore dello strato viscoso viene effettivamente ridotto da una pressione della camera di reazione inferiore, aumentando così il tasso di crescita epitassiale. Allo stesso tempo, la sua camera di reazione non ha una parete superiore su cui le particelle SIC possono essere depositate e non è facile produrre oggetti in caduta. Ha un vantaggio intrinseco nel controllo dei difetti. I modelli rappresentativi sono i forni epitassiali a valle singoli epirevos6 e epirevos8 del nuflare giapponese.
Secondo NuFlare, il tasso di crescita del dispositivo EPIrevos6 può raggiungere oltre 50 μm/h e la densità del difetto superficiale del wafer epitassiale può essere controllata inferiore a 0,1 cm-²; In termini di controllo dell'uniformità, l'ingegnere Nuflare Yoshiaki Daigo ha riportato i risultati di uniformità intra-wafer di un wafer epitassiale da 6 pollici spesso 10 μm coltivato usando Epirevos6 e lo spessore intra-wafer e la non uniformità del doping hanno raggiunto rispettivamente l'1% e il 2,6%. Stiamo fornendo parti di grafite ad alta purezza con rivestimento a coata come Sic come parti di grafite ad alta purezza con la grafite ad alta purezza come la grafite ad alta purezza con la grafite ad alta purezza con la grafite ad alta purezzaCilindro di grafite superiore.
Al momento, i produttori di apparecchiature nazionali come Core Thir Generation e JSG hanno progettato e lanciato apparecchiature epitassiali con funzioni simili, ma non sono stati utilizzati su larga scala.
In generale, i tre tipi di attrezzature hanno le proprie caratteristiche e occupano una certa quota di mercato nelle diverse esigenze di applicazione:
La struttura CVD orizzontale a parete calda presenta un tasso di crescita ultra-veloce, qualità e uniformità, funzionamento e manutenzione delle apparecchiature semplici e applicazioni di produzione su larga scala mature. Tuttavia, a causa del tipo singolo-wafer e della frequente manutenzione, l'efficienza di produzione è bassa; Il CVD planetario a parete calda adotta generalmente una struttura del vassoio da 6 (pezzo) × 100 mm (4 pollici) o 8 (pezzo) × 150 mm (6 pollici), che migliora notevolmente l'efficienza di produzione dell'attrezzatura in termini di capacità di produzione, ma è difficile controllare la coerenza di più pezzi e il rendimento di produzione è ancora il problema più grande; Il CVD verticale a parete quasi foro ha una struttura complessa e il controllo del difetto di qualità della produzione di wafer epitassiale è eccellente, che richiede un'esperienza di manutenzione e utilizzo delle attrezzature estremamente ricca.
Tasso di crescita rapido
semplice Struttura dell'attrezzatura e
comoda manutenzione
Grande capacità produttiva
Elevata efficienza di produzione
Buon controllo del difetto del prodotto
Camera di reazione lunga
ciclo di manutenzione
Struttura complessa
difficile da controllare
coerenza del prodotto
Struttura di attrezzatura complessa,
Maintenzione difficile
Rappresentante
attrezzatura
produttori
CVD orizzontale a parete calda
CWD planetario a parete calda
CTD verticale a parete quasi foro
Vantaggi
Svantaggi
Breve ciclo di manutenzione
Italia LPE, Giappone Tel
Germania Aixtron
Giappone Nuflare
Con il continuo sviluppo del settore, questi tre tipi di attrezzature saranno ottimizzati e aggiornati iterativamente in termini di struttura e la configurazione dell'attrezzatura diventerà sempre più perfetta, svolgendo un ruolo importante nell'abbinare le specifiche dei wafer epitassiali con diversi spessori e requisiti di difetto.



+86-579-87223657


Wangda Road, Ziyang Street, contea di Wuyi, città di Jinhua, provincia di Zhejiang, Cina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Tutti i diritti riservati.
Links | Sitemap | RSS | XML | politica sulla riservatezza |
